近日,美国研究人员表示氮化镓(GaN)表面进行氮化镓再生长技术有了新的突破。对于垂直GaN二极管再生长技术,这次主要是针对于击穿电压的研究。研究人员声称,他们已经成功研制了GaN环境下目前拥有最高击穿电压(1.1kV)的垂直再生长二极管。
近日,美国康奈尔大学联合诺特丹大学以及IQE RF LLC公司共同研发出一款再生长GaN二极管,研究人员表示这次的突破是理解再生长结构导通机制的重要一步,也是高性能垂直GaN开关的选择性掺杂技术的关键一环。
结构
该器件的底层结构由GaN衬底构成,再通过金属有机化合物化学气相沉淀(MOCVD)工艺在其表面生长8微米厚含有~2x1016/cm3浓度硅掺杂的GaN层。上表面再用盐酸清洗,并使用分子束外延(MBE)在清洁的表面镀上400nm ~1018/cm3的镁掺杂P-GaN层和20nm的p++-GaN保护层。
如图1所示,整个P极的结构为梯形,并生长在n型掺杂的GaN结构上。正极材料采用了钯或者金,负极材料采用了钛或者金。整个器件使用旋涂式玻璃层覆盖。
为什么不用MOCVD镀膜?
其实,研究人员发现,MOCVD工艺在再生长中存在一些缺陷,比如在一些非平面结构中的高几率缺陷以及晶向掺杂中的高依赖性。同时,由于镁记忆/扩散效应,在该工艺下,p型和n型掺杂材料的交界处会生长出尖锐边缘。除此之外,MOCVD中的氢气也会影响p型掺杂层中的镁。
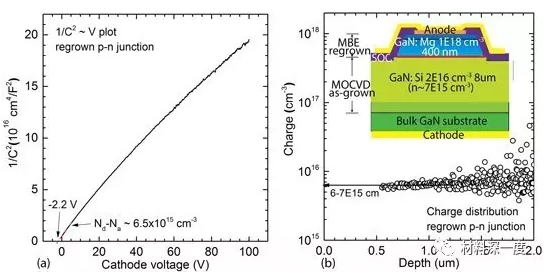
图1 (a)再生长GaN二极管中的1/C2~V特性曲线(b)器件结构图以及n-GaN漂移层中的掺杂浓度变化
特性与优点
通过电容电压测量方法,研究人员发现相比原生结构的二极管内建电压(~3.2V),再生长结构有一些降低(~2.2V)。这种电压的变化极有可能是由于禁带的变化以及缺陷密度上升。
研究人员同样表示,对于原生的二极管,这种二极管在300-600nm之前的光谱强度是之前的三十分之一。这意味着这种再生长二极管拥有更多的非辐射性复合过程。
与此同时,在一定温度范围内(25-125°C)工作电阻(Ron)会随之上升。这一趋势意味着Ron的变化主要取决于n型掺杂层的电阻(rn)。因为,位于较低位错密度中,n型掺杂的GaN中的电子迁移率受到了声子散射的影响,从而随着温度的上升,迁移率开始下降,电阻随之上升。
根据研究人员测量,对于一个直径为107微米的器件来说,最大的反向击穿电压为1136V,在击穿之前的漏电流的密度只有0.1A/cm2。而且,对于这种二极管,并未检测到雪崩击穿效应发生。
参考文献
Z. Hu; K. Nomoto; M. Qi; W. Li; M. Zhu; X. Gao; D. Jena; H. G. Xing, "1.1 kV Vertical GaN p-n Diodes with p-GaN Regrown by Molecular Beam Epitaxy," in IEEE Electron Device Letters , vol.PP, no.99, pp.1-1doi: 10.1109/LED.2017.2720747




