近日,深圳大道半导体有限公司与佛山市国星半导体有限公司合作开发成功了新一代自带导热焊垫的大倒装芯片级封装(CSP)光源。
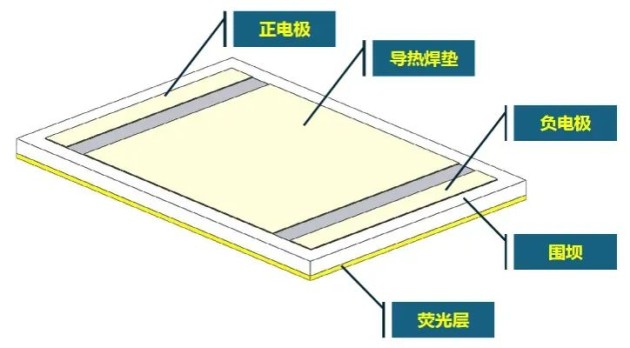
据介绍,制造传统大功率LED光源的主要技术包括采用共晶焊接技术,把含金锡焊垫的大功率倒装芯片共晶焊接到用DPC工艺制造的氮化铝陶瓷基板上,在倒装芯片四周设置围坝和在倒装芯片表面涂敷荧光层(包括喷涂、压膜等工艺技术)后,再通过真空回流技术把导热性能优异的氮化铝陶瓷基板焊接到热电分离铜板上。
由于金锡焊垫和氮化铝陶瓷基板成本高,共晶焊接工艺要求苛刻,导致采用传统大功率LED芯片和封装结构制造的大功率LED光源价格昂贵,只能应用于高端方向性投射类照明灯具上。
该光源在结构与制造工艺上主要创新包括:
1. 自带导热焊垫的大功率倒装芯片结构,具体细节发表在大道半导体名下的三项授权发明专利(201310047522.2,201310093759.4和201310307147.0)中,内容涵盖倒装芯片的深刻蚀侧壁保护、侧壁反射层、自带导热焊垫和倒装芯片内三维布线结构等;
2. 不再使用价格昂贵的氮化铝基板,单片光源厚度减少约0.4mm,应用于汽车前大灯时,可提升聚光性能,并减少暗区面积;
3. 省略了焊接工艺要求苛刻的共晶焊技术;
4. 大功率倒装芯片不再使用价格昂贵的金锡焊垫;
5. 采用CSP封装技术和结构,具体细节发表在大道半导体名下的二项实用新型发明专利(202020612786.3和2025204230491)以及25项外观专利中,内容涵盖大倒装CSP光源和带铜板的大倒装CSP光源组成和结构,以及自带导热焊垫的大倒装芯片外观和大倒装CSP光源外观等;
6. 新一代大功率CSP光源直接真空回流焊接到热电分离的铜线路板上。
新一代大倒装CSP光源的整个制造工艺流程简单,可靠,无需使用材料成本中最昂贵的金锡焊垫和氮化铝基板,涉及的工序与设备大幅减少,也避免了工艺要求苛刻的共晶焊接,在不损失LED主要光电性能的基础上,可以降低制造成本,为高端方向性投射类照明灯具提供了光源选择。
此外,该产品应用高压倒装芯片技术,可实现6伏、9伏或更高电压运行,无需通过芯片集成实现高电压驱动。其结构消除了芯片拼接间隙,提高光集中度,避免暗纹,发光面积更小,从而提升中心照度与投射距离,为大功率LED在车灯及高端照明等方向性投射场景中的应用提供了可能性。
来源:大道半导体



